Please select your location and preferred language where available.
3次元フラッシュメモリの高積層化に伴い難易度が上昇している製造工程(プロセス)の一つに、高アスペクト比(HAR:High Aspect Ratio)のホールやトレンチのエッチングプロセスが挙げられます。均一なHAR加工形状を形成する高精度なエッチングプロセス制御を可能にするために、HAR加工形状を非破壊かつ高精度に計測する技術が必要とされています。
T-SAXS(透過型X線小角散乱)は透過X線を活用した形状計測技術です。図1に示すようにウエハの角度を回転させながら取得した複数枚のX線回折像(SAXS像)を用いる事で、HAR加工形状を非破壊かつ高精度に計測する技術として期待されています。我々はT-SAXSのX線回折像シミュレーションによって、将来の3次元フラッシュメモリにおけるHAR加工形状計測可能性検証を行った結果について報告しました。検証結果より、T-SAXSを用いる事で深さ30μm(アスペクト比300)のHARホール形状に対しても、計測誤差1%未満と高精度な計測ができる事を確認でき、高アスペクト化する3次元フラッシュメモリの形状計測に対するT-SAXSの高い拡張性を確認できました。
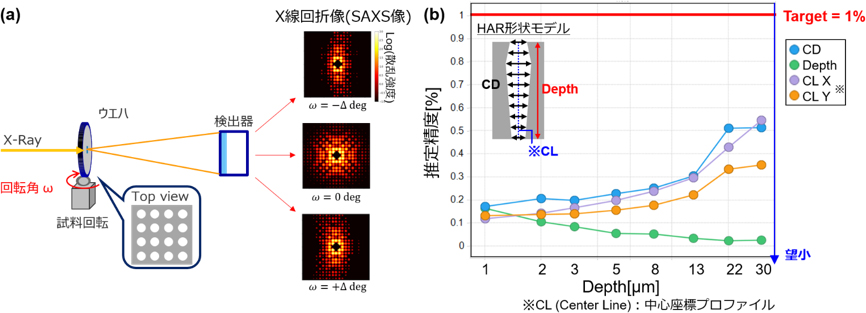
本技術については、2021年2月に開催された国際会議SPIE AL(Society of Photo-Optical Instrumentation Engineers Advanced Lithography)[1]、2021年10月に開催された第41回ナノテスティングシンポジウムにて発表を行いました[2]。
本稿は、文献[1],[2]から図面等一部抜粋&再構成したものです。
文献
[1] Kaori Sasaki, Takaki Hashimoto, Yenting Kuo, Hiroshi Tsukada, and Hiroyuki Tanizaki "Measurability analysis of the HAR structure in 3D memory by T-SAXS simulation",
Proc. SPIE 11611, Metrology, Inspection, and Process Control for Semiconductor Manufacturing XXXV, 116110U (22 February 2021) © 2021 Society of Photo Optical Instrumentation Engineers (SPIE).
[2] Kaori Sasaki, Takaki Hashimoto, Yenting Kuo, Hiroshi Tsukada, and Hiroyuki Tanizaki "Measurability analysis of the HAR structure in 3D memory by T-SAXS simulation", The 41st Annual NANO Testing Symposium, Metrology and Inspection, (2) (25 October 2021) © 2021 The institute of NANO Testing (INANOT).

