Please select your location and preferred language where available.
酸化物半導体のひとつであるInGaZnOは、広いバンドギャップと高い電子移動度という特徴から、超低リークかつ高いオン電流を有するトランジスタの実現が期待されます。また、InGaZnOを用いた縦型トランジスタは、基板浮遊効果や接合欠陥に起因する不良を起こしにくいため、4F2型DRAMへ適用することで、低消費電力かつ高信頼な新型DRAMの実現が期待されます(図1)。
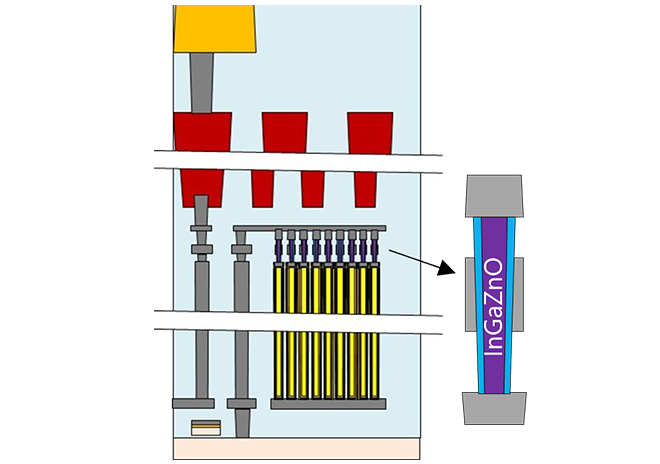
InGaZnOトランジスタを、高速動作が必要なDRAMへ適用するには、1µA以上のオン電流が必要となります。我々は電極材料やスペーサー膜厚を最適化することで、15µAという高いオン電流を実現しました(図2)。
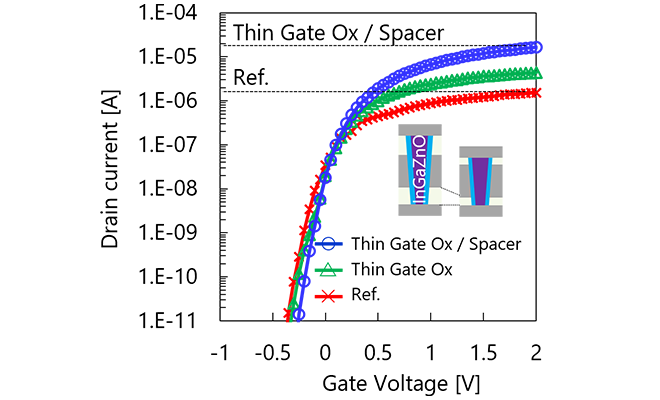
また、InGaZnOの広いバンドギャップを反映して、10-18A(1aA)という極めて低いリーク電流を実証しました(図3)。

これら高オン電流かつ低オフリークの特徴を持つInGaZnOトランジスタをDRAMのセルトランジスタに適用した「OCTRAM」を、南亜科技と共同で試作しました(図4)。
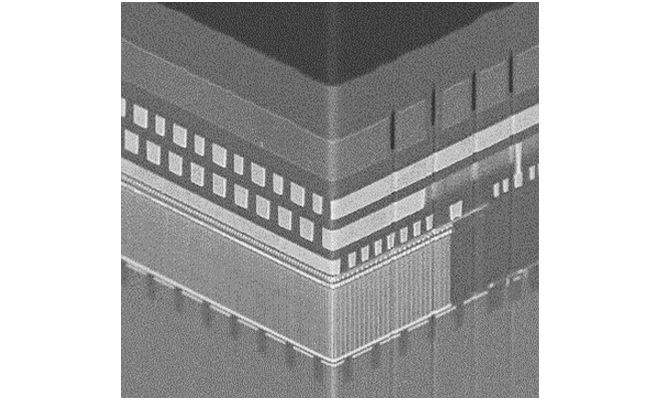
キャパシタの上にセルトランジスタを配置する「キャパシタ1st」構造を採用することで、プロセスインテグレーションを容易化しました。試作したOCTRAMは所望の電圧範囲で書換え動作が可能であり、100秒を超える長リテンション性能を実証しました(図5)。これにより、AIやポスト5G情報通信システムで利用される大規模メインメモリが搭載されるサーバーや、IoT製品などの幅広いアプリケーションにおいて、低消費電力化を実現する可能性があります。
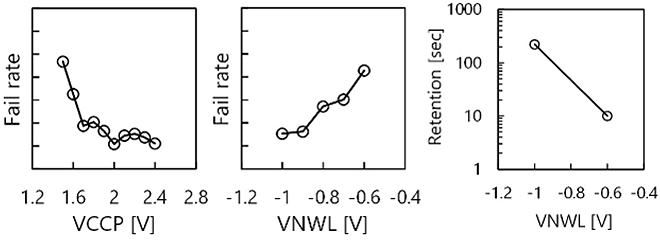
(右)リテンションとトランジスタオフ電圧(VNWL)との関係[1] ©2024 IEEE
本成果は2024年12月に開催されたIEEE IEDM 2024において発表されました。
文献
[1] S. Fujii et al., “Oxide-semiconductor Channel Transistor DRAM
(OCTRAM) with 4F2 Architecture”, 2024 IEEE International Electron Devices Meeting (IEDM)

