Please select your location and preferred language where available.
5G時代到来により、半導体機器の小型化かつ低消費電力化がよりいっそう望まれています。こうした背景から、(1)バンドギャップが広い(~3 eV)ためオフ電流が極めて小さい、(2)非晶質ながら移動度が比較的高い(~10 cm2/Vs) 、(3)配線工程と整合性の高い低温プロセス(<400℃)[1]、といった特徴を持つ酸化物半導体InGaZnO(IGZO)をチャネル材料に用いた酸化物半導体FET(oxide-semiconductor field-effect transistor)が近年注目を集めています。酸化物半導体FETの課題の一つは、熱安定性、中でもSi CMOS LSI形成において必要なフォーミングガス(N2/H2)中での熱処理耐性の向上です。
この課題に対し、私達はIGZOにフッ素を添加した新規材料(IGZO:F)を用いることで、FETの熱安定性の向上、すなわち400℃のフォーミングガスアニール後における閾値電圧の負シフトの抑制に成功しました(図1)。さらに、そのメカニズムを原子レベルで明らかにし、材料設計の指針を提示するため、第一原理計算による検証を行いました。その結果、IGZO:FではIGZOに比べて酸素欠損の形成エネルギーが高くなることで、熱安定性が向上することを見出しました(図2)。
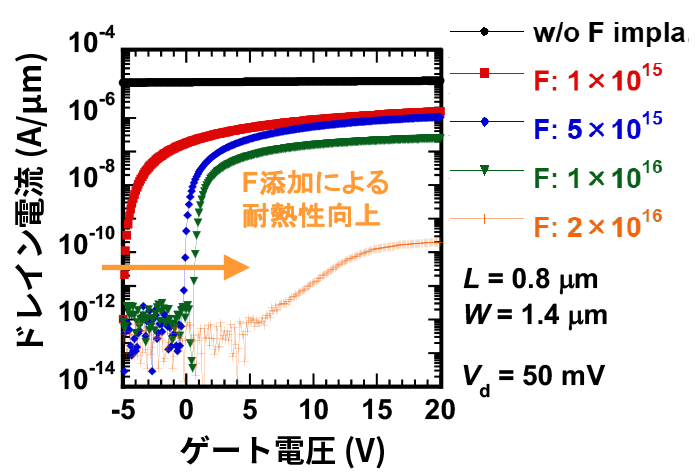

一方、過剰なフッ素の添加は金属原子間の結合に由来する電子トラップ状態を形成し、FETのオン電流値を低下させることも明らかになりました。しかし、添加フッ素量を最適化したIGZO:Fを用いる事で、フォーミングガス熱処理耐性と高オン電流が両立した酸化物半導体FETを実現できることを示しました(図3)。これらの成果は、シリコンFETでは成しえない大容量・低遅延・超低消費電力なメモリ製品を実現する基盤技術の一つとなります。

本技術は2020年12月に開催された国際学会IEDM (International Electron Devices Meeting) において招待講演を行いました[2]。
[1] K. Nomura, H. Ohta, A. Takagi, T. Kamiya, M. Hirano, and H. Hosono, “Room-temperature fabrication of transparent flexible thin-film transistors using amorphous oxide semiconductors”, Nature, 432(7016), pp. 488-492, (2004)
[2] H. Kawai, H. Fujiwara, J. Kataoka, N. Saito, T. Ueda, T. Enda, T. Ishihara, and K. Ikeda, “2 Design Principle of Channel Material for Oxide-Semiconductor Field-Effect Transistor with High Thermal Stability and High On-current by Fluorine Doping”, 2020 IEEE IEDM, 22.2.
本稿は、文献[2]© 2020 IEEEから図面等一部抜粋&再構成したものです。
記載されている社名・商品名・サービス名などは、それぞれ各社が商標として使用している場合があります。

